2021-01-06 宜錦科技
隨5G、物聯網、電動車蓬勃發展,對於低功耗要求越來越高,功率半導體成為這些產業勢不可擋的必備組件。 Propowertek宜錦宣布,成功開發晶圓減薄達1.5mil(38um)技術,通過客戶肯定,技術門檻大突破。
Propowertek宜錦指出,功率半導體進行「減薄」,一直都是改善製程、使得功率組件實現「低功耗、低輸入阻抗」最直接有效的方式。晶圓減薄除了有效減少後續封裝材料體積外,還可因降低RDS(on)(導通阻抗)進而減少熱能累積效應,以增加芯片的使用壽命。 。
但如何在薄化製程中降低晶圓厚度,又同時兼顧晶圓強度,避免破片率居高不下之風險自晶圓薄化最大的風險。
為解決此風險,Propowertek宜錦領先業界,已完成2mil(50um)、1.5mil(38um),甚至到0.4mil(10um)薄化技術開發,Propowertek宜錦更藉由特殊的優化製程,在降低晶圓厚度的同時,也兼顧晶圓強度,可將研磨損傷層(Damage layer)降到最低。
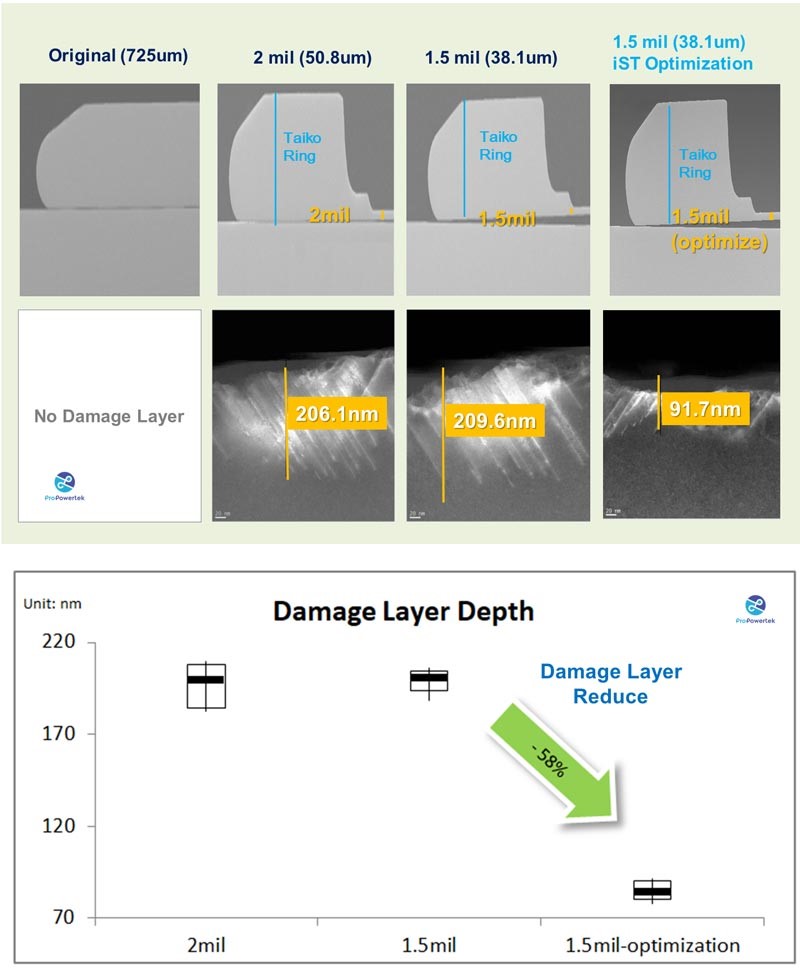
以上與您分享宜錦的最新技術,
若您有相關需求,Propowertek宜錦可以配合您進行後續的工程開發,
為您提供Power MOSFET/IGBT等元件的薄化強度改善,歡迎洽詢。

