IGBT晶圆后段制程
IGBT Wafer Backend Process
- Home
- /
- IGBT背面金属溅镀沉积
IGBT背面金属溅镀沉积 (IGBT Back Side Metal Sputtering Deposition)

背面金属溅镀沉积 (Back Side Metal Sputtering Deposition),是利用高真空的环境,将氩原子 (Ar) 解离后,产生二次电子和氩 (Ar) 离子,再利用靶材上的负电位,使氩 (Ar) 离子加速撞击靶材,使靶材上的金属沉积在晶片表面上。
ProPowertek宜锦能为您做什么?
可提供背面金属溅镀沉积 (Back Side Metal Sputtering Deposition),可以在晶圆完成了研磨等薄化步骤后,利用特殊设计的机台,自动化为客户制备焊垫金属层,如MOSFET需求的钛 / 镍钒/ 银 (Ti / NiV / Ag),以及IGBT需求的铝 / 钛 / 镍钒/ 银 (Al / Ti / NiV / Ag)。
背面金属溅镀沉积 (Back Side Metal Sputtering Deposition)流程
机台会有固定时间,周期性的进行机台稳定度的检测,利用控片分别进行各反应腔(Chamber)的测试,在ICP反应腔中会进行蚀刻率测试,在铝(Al)、钛(Ti)、镍钒(NiV)、银(Ag)则会分别进行沉积率及均匀性的预测试,确定了机台状况一如往常的平稳后,产品会依照排程开始进入生产,客户的晶圆在完成入站检验 (IQC) 后,客户可要求进行沉积前DHF清洗或是直接进入溅镀机,按照客户指示之种类及厚度及ICP条件,进行金属沉积 (Sputtering Deposition),完成金属沉积后,可依客户需求进行沉积后之氮气退火,或是直接进行出站检验 (OQC)。

ProPowertek宜锦服务优势
▶ 提供铝 / 钛 / 镍钒/ 银 (Al / Ti / NiV / Ag)及钛 / 镍钒/ 银 (Ti / NiV / Ag)的金属组合。
▶ 可以全自动进行薄片溅镀,无需人员手动操作。
▶ 可以提供溅镀前清洗,避免原生氧化层产生,促进铝突(Al Spiking)形成。
▶ 可以提供氮气高温烤箱,依客户需求进行金属后回火。
▶ 溅镀金属附着性良好,在高温高湿85℃/ 85%、1000小时可靠度验证下,无金属剥离 (Metal Peeling) 情况。
▶ 可依客户需求控制铝突产生。
▶ 工程师团队背景多元化,有来自前段晶圆代工厂、晶圆薄化专家、后段封装厂,熟悉前中后段之制程整合及分析,能协助客户快速开发、解决问题、稳定量产。
案例分享
无金属剥离 (Non-metal Peeling)
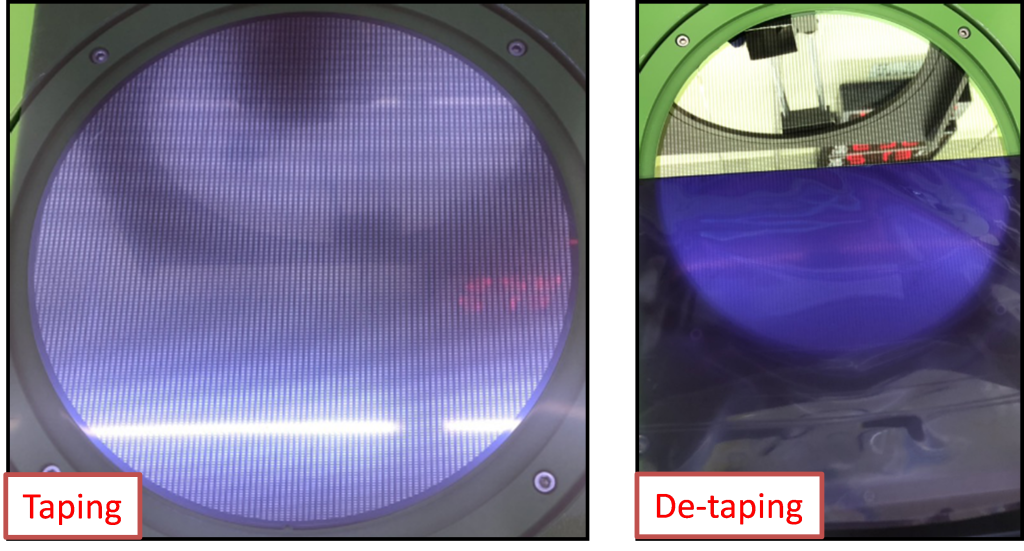
溅镀金属后进行蚀刻间隙后,以胶带进行peeling test,无金属剥离的情况。
高温高湿85度℃ 85%的 1000小时可靠度验证,并进行晶粒挑拣 (Die Sawing) 后,以Blue Tape进行金属剥离测试Peeling test,无任何剥离 (Peeling) 产生。

N-type 晶圆进行peeling test
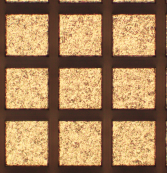
P-type晶圆进行peeling test

依照JESD22-B117B规范进行推球实验,推力均大于350gf以上,高于Automotive 规格226gf


铝突的观察:金属成长后,去除金属可在矽表面可观察到铝突所形成的凹陷

因为铝突形成,对电性的改善
应用范围
⏺︎ 现有金属组合:铝 / 钛 / 镍钒/ 银 (Al / Ti / NiV / Ag)或钛 / 镍钒 / 银 (Ti / NiV / Ag) ,可依客户需求进行厚度调整
⏺︎ 适用八吋晶圆
⏺︎ 铝 / 钛 / 镍钒 /银 (Al / Ti / NiV / Ag) 成长的均匀性极佳
⏺︎ MOSFET及IGBT背面金属层

